不揮発性メモリ素子が壊れる瞬間を可視化 ―電子デバイスの新たな非破壊顕微解析手法を開発―
東京大学
発表のポイント
- 大規模集積化が可能なメモリ素子の新材料HfO2系強誘電体を用いたキャパシタが100万回以上のデータ書き換えによって絶縁破壊する様子を電極越しに可視化することに成功した。
- レーザー励起光電子顕微鏡によって、絶縁破壊後の電気伝導パスだけでなく絶縁破壊直前のリーク電流の増加領域の可視化に初めて成功し、キャパシタ内の広い範囲で抵抗が変化していることを解明した。
- 三次元化が進む半導体デバイスの新たな非破壊顕微分析手法として、学術界・産業界ともに広く利用されることが期待される。
発表概要
東京大学物性研究所の藤原弘和特任研究員、同大学大学院新領域創成科学研究科のバレイユ・セドリック特任研究員(研究当時)、谷内敏之特任准教授、同大学の辛埴特別教授らの研究グループは、東京大学生産技術研究所の糸矢祐喜大学院生(工学系研究科博士課程)、同大学大学院工学系研究科附属システムデザイン研究センターの小林正治准教授らの研究チームと共同で、世界で初めて二酸化ハフニウム(HfO2)系強誘電体(注1)が 絶縁破壊(注2)を起こす様子を電極越しに可視化することに成功しました。
HfO2系強誘電体は薄膜でも十分な強誘電性を持ち、高密度集積が可能という特徴を持つため、大容量強誘電体メモリに実装可能な材料として注目を集めています。他方、HfO2系強誘電体は保持電界が絶縁破壊電界に匹敵する大きさであり耐久性が低いという課題がありました。この課題を解決するために、絶縁破壊に至る過程の観察と原理解明が望まれていました。本研究では、電気計測システムを実装したレーザー励起光電子顕微鏡(Laser-PEEM、注3)を用いることで、HfO2系強誘電体キャパシタの絶縁破壊過程を、電極を「透かして」観察することに成功しました。この技術により、これまではデバイスを加工しなければ観察できなかったデバイス内部の不良原因を非破壊で観察できるようなります。強誘電体メモリデバイスだけでなく、三次元化の進むロジックデバイスやフラッシュメモリの分析にも利用できる強力なツールとなり得ます。
本成果はアメリカ物理学協会が発行するApplied Physics Lettersの10月24日(現地時間)に掲載されました。
全文PDF発表内容
研究の背景
近年、IoTデバイスやウェアラブルテクノロジーの急速な普及に伴い、低消費電力で高速なメモリ技術への要求が増しています。強誘電体メモリ(FeRAM、注4)は、強誘電体の分極を利用して電源がオフの状態でもデータを保持できるメモリで、高速、低消費電力という特徴を持つことから、交通系ICカード等に用いられてきました。しかし、従来の強誘電体材料では、小さな保持電界や材料固有のサイズ効果などの理由で膜厚が数100ナノメートルを要し、メモリデバイスの微細化が難しく、集積デバイス技術として大きな市場を形成することはできませんでした。
そんな中、CMOS(注5)プロセスで用いられているHfO2系材料において強誘電性が発現することが発見されました。この材料は、10 ナノメートル以下に薄膜化してもリーク電流を抑えて強誘電性を示すこと、大きな保持電界を持つこと、10ナノ秒以下でスイッチングが可能なことが知られており、先述の強誘電体の微細化の課題を克服できる材料として注目されています。こうした特性から、パソコンやスマートフォンのワーキングメモリとして利用されるDRAMをFeRAMで置き換えられる可能性が出てきました。それに向けた残された課題の一つは書き込み耐性です。FeRAMをワーキングメモリとして利用するには109回から1015回の書き換え耐性が要求されます。しかし、HfO2系強誘電体キャパシタの典型的な書き込み耐性は106回から109回の間です。書き込み耐性を向上するには、絶縁破壊を抑制する必要があり、絶縁破壊過程の解明が急務でした。これを実験的に解明するには、デバイス形状を維持したまま、非破壊的な顕微手法でデバイスを観察することが求められていました。
研究の内容
本研究チームは、基礎材料科学の分野で使われてきたレーザー励起光電子顕微鏡という手法をデバイス観察に適用しました。Laser-PEEMは、紫外線レーザーを物質に照射し、光電効果によって真空中に放出した電子(光電子と呼ぶ)を電子光学システムによって拡大投影することで顕微像を得る手法です。固体中の電子は、電気伝導等の物理的性質を支配していると同時に物質の化学的な情報をまとっているため、その電子を直接的に観察できる本手法は、材料が示す様々な特性を理解するのに役立ちます。本研究チームは、デバイスへ電圧を印加しながら欠陥密度が変化する様子を観察できるように電気計測システムを実装した「オペランドLaser-PEEM」装置を開発しました。この装置の特徴をまとめると、① 収差補正技術と連続波レーザーの組み合わせにより約3ナノメートルの解像度を持つ、② 4.66 eVという低いエネルギーのレーザーを用いることで、欠陥に敏感な測定ができ、かつ約100ナノメートルにも及ぶ検出深さを持つ、③ 顕微鏡観察と同時に書き換え耐性を評価できるため、書き換え電圧印加以外のデバイスの特性変動要因を排除できる、などが挙げられます。
この装置を用いて、HfO2系強誘電体の中でも比較的耐久性の高いHf0.5Zr0.5O2を使ったクロスバー型キャパシタの絶縁破壊過程を調査しました。それにより、絶縁破壊後の電気伝導パスを30ナノメートル厚の電極越しに明瞭に可視化することに成功しました(図2右上)。さらに、完全な絶縁破壊の直前にわずかなリーク電流が増加するという絶縁破壊の「前兆」があり、この時にキャパシタの1/4程度の範囲に渡って欠陥密度が増加した様子を世界で初めて可視化しました(図2中上)。従来、絶縁破壊直前のリーク電流の増加は、強誘電体膜中の全体に渡る欠陥の増加か、または局所的な伝導フィラメントの成長によるものであると考えられていました。今回の研究結果から、それらの絶縁破壊過程モデルとは異なり、キャパシタの中の一部の領域でのみ欠陥密度が増加、それに伴い抵抗が変化するということを明らかにしました。
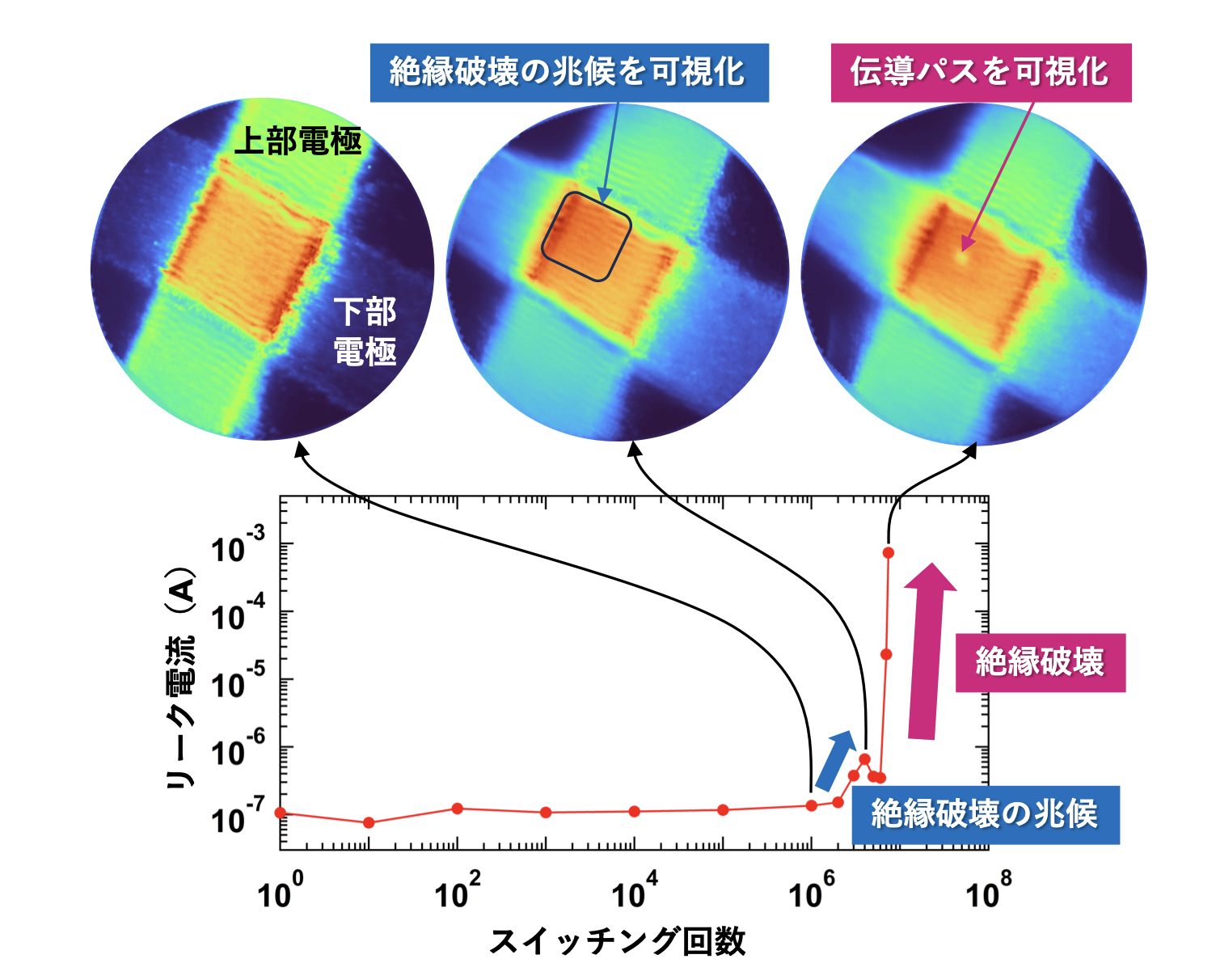
リーク電流計測で絶縁破壊の兆候が観測されたと同時に、キャパシタの左上の領域で欠陥密度が増加していることが示された。絶縁破壊後のPEEM観察像では、伝導パスが明瞭に可視化されている。
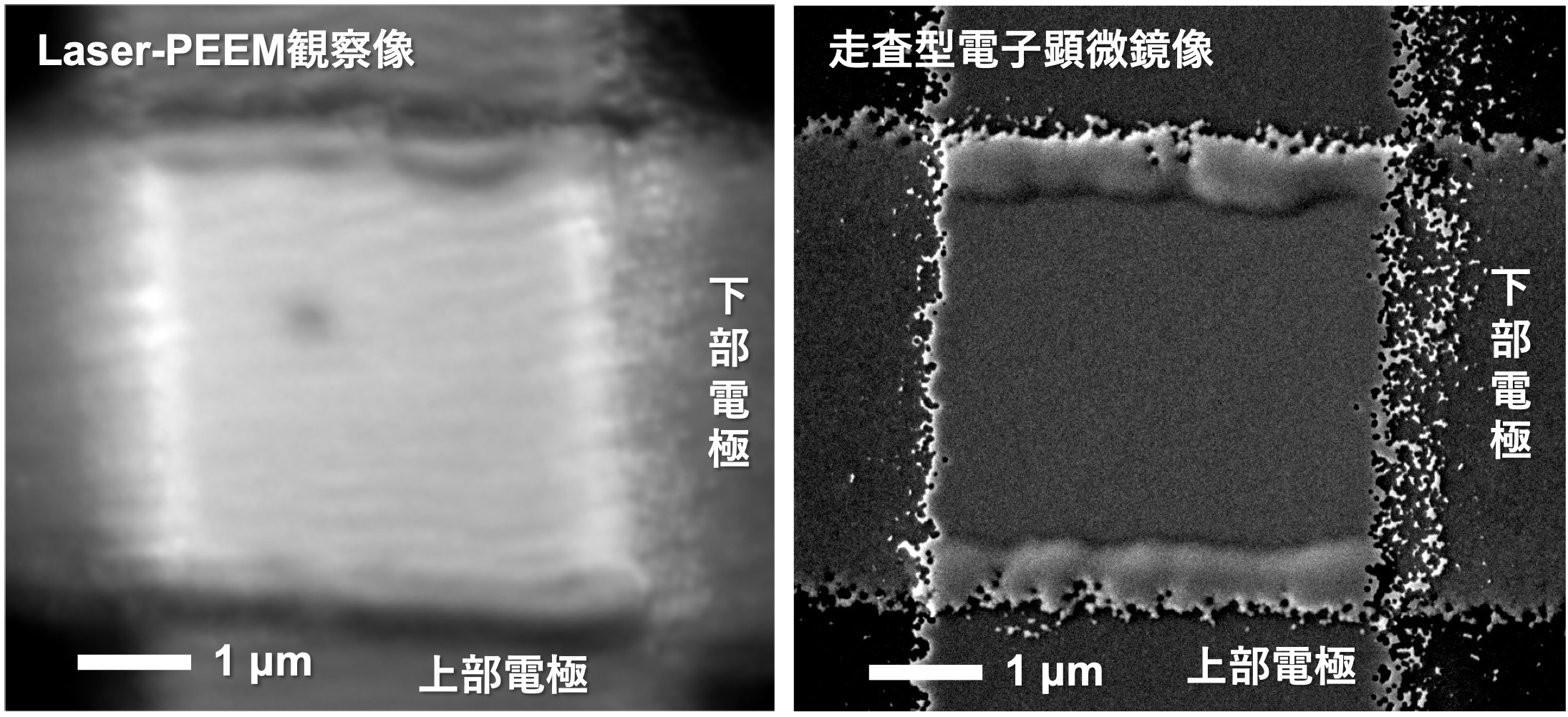
走査型電子顕微鏡の検出深さは1から10ナノメートル程度であり、30ナノメートルの上部電極越しに伝導パスを観察することが困難である。一方、Laser-PEEM像では伝導パスが可視化できることが明瞭に示された。この比較から、Laser-PEEMは走査型電子顕微鏡よりも深くに埋もれた層を観察可能であることがわかる。
今後の展望
今回の実験研究によって、より正確な絶縁破壊過程モデルが明らかとなり、強誘電体メモリデバイスの高信頼性化が加速するものと期待されます。さらに本研究では、Laser-PEEMが欠陥密度の変化を非破壊で観察できることを実証しました。電子デバイスを構成する材料として、多結晶シリコンやシリコン窒化膜、金属酸化物など、欠陥密度の変化が電子デバイスのパフォーマンスや信頼性を支配しているものが多く使われています。今後、単一デバイスの研究から製品に近い大規模集積回路の検査に至るまで広くLaser-PEEMが利用され、半導体製品の高性能化、低コスト化にも貢献するものと期待されます。
発表者
- 東京大学
- 物性研究所 附属極限コヒーレント光科学研究センター
- 藤原 弘和(特任研究員)
- 大学院新領域創成科学研究科
- バレイユ セドリック(特任研究員)〈現在:株式会社日立ハイテク〉
- 谷内 敏之(特任准教授) 〈東京大学連携研究機構マテリアルイノベーション研究センター〉
- 生産技術研究所
- 糸矢 祐喜(大学院生)〈大学院工学系研究科 博士過程〉
- 大学院工学系研究科 附属システムデザイン研究センター
- 小林 正治(准教授)
- 物性研究所 附属極限コヒーレント光科学研究センター
論文情報
- 〈雑誌〉 Applied Physics Letters
- 〈題名〉 Non-Destructive Imaging of Breakdown Process in Ferroelectric Capacitors Using In-situ Laser-Based Photoemission Electron Microscopy
- 〈著者〉 Hirokazu Fujiwara * , Yuki Itoya, Masaharu Kobayashi, Cédric Bareille, Shik Shin, and Toshiyuki Taniuchi
- 〈DOI〉 10.1063/5.0162484
- 〈URL〉 https://doi.org/10.1063/5.0162484
研究助成
本研究は、日本学術振興会の科研費「酸化物半導体と強誘電体HfO2の融合による三次元集積デバイスとその応用技術の創出(課題番号:21H04549)」、「非破壊オペランドナノイメージングで可視化する酸化物デバイスの特性変動過程(課題番号:23K13363)」、一般財団法人材料科学技術振興財団研究助成、公益財団法人精密測定技術振興財団研究助成および株式会社日立ハイテク寄付金の支援により実施されました。
用語解説
- (注1)強誘電体:
- 外部から電界を受けると巨視的な電気分極を示す物質です。この電気分極は、外部の電界がなくなった後も残り続けます。これを残留分極といいます。この残留分極の向きは簡単には変わらないため、残留分極の向きによってデジタルデータを記録することができます。
- (注2)絶縁破壊:
- 絶縁体材料が極端な電圧ストレスに晒されると発生する現象です。これにより、本来電流を通さないはずの絶縁体が金属的にふるまうようになり、デバイスの異常や故障を引き起こします。絶縁破壊は、電子デバイスの信頼性や耐久性を低下させ、寿命を縮める重要な要因となります。
- (注3)レーザー励起光電子顕微鏡(Laser-based PhotoEmission Electron Microscope: Laser-PEEM):
- 物質からの光電子の放出を観察するための高度な顕微鏡です。レーザー光を用いて物質内部の電子を励起し、放出された光電子のエネルギーや空間分布を分析します。これにより、物質の電子状態の空間分布を非破壊でリアルタイムに観察することができます。
- (注4)強誘電体メモリ(Ferroelectric Random Access Memory: FeRAM):
- 強誘電体が持つ自発分極の向きを利用した不揮発性メモリです。電源がオフの状態でもデータを保持できます。1個のトランジスタと1個の強誘電体キャパシタで構成されるメモリセルは比較的セル面積が小さく、低消費電力DRAMとして用いることが検討されています。
- (注5)CMOS(Complementary Metal-Oxide-Semiconductor):
- 低消費電力のデジタル回路を実現するための半導体技術です。NMOSとPMOSと呼ばれる二つのタイプの金属-酸化物-半導体電界効果トランジスタ(MOSFET)を使います。これらのトランジスタは相補的に動作し、消費電力を大幅に削減します。CMOS技術は、マイクロプロセッサ、メモリ、その他多くのデジタルロジックICで広く採用されています。